
01/简介
为验证矢量HSMO技术对工艺窗口(PW)的优化效果,采用考虑离焦的像质评价函数

02/仿真条件
以AttPSM为例,对比HSMO(联合优化光源+掩模)与OPC(仅优化掩模,光源不变)技术。仿真目标图形包括一维孤立线条(占空比1:4,CD=45nm)、一维半密集线条(占空比1:2,CD=45nm)、二维密集接触孔(占空比1:1,CD=60nm)。
仿真采用193nm浸没式光刻系统,取有限掩模区域仿真,孤立线条、半密集线条、密集接触孔的掩模尺寸分别为3420nm×3420nm、3060nm×3060nm、2640nm×2640nm,掩模像素尺寸分别为12nm×12nm、12nm×12nm、16nm×16nm,掩模矩阵大小分别为285×285、255×255、165×165。HSMO采用41×41光源矩阵(密集采点),OPC采用9×9光源矩阵(稀疏采点)。
03/掩模延拓和测量点
为量化工艺变化稳定性,需计算初始光源掩模、OPC优化后、HSMO优化后的PW。HSMO优化后的掩模需进行周期性延拓(如图所示),并在半密集线条、孤立线条的上边缘、中心线、下边缘设3个PW测量点,密集接触孔仅在中心线设1个测量点,以重叠PW作为评价指标。

采用HSMO优化后的掩模图形
04/仿真参数与流程
关键参数:NA、相干因子σin/σout、优化步长SΩ、罚函数加权系数γS/γD/γW等可见表格。
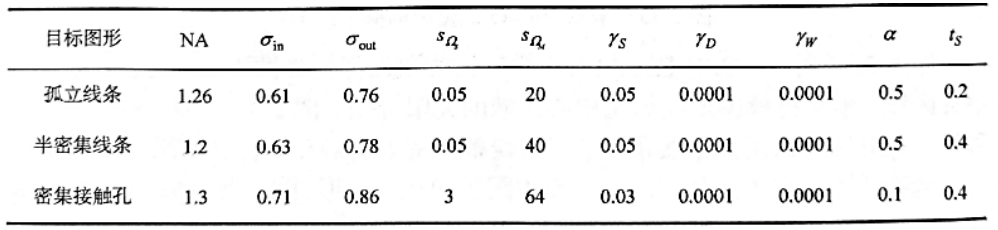
采用孤立线条、版密集线条和密集接触孔的OPC和HSMO仿真参数

采用孤立线条、版密集线条和密集接触孔的OPC和HSMO仿真结果
05/PW扩展效果
损失函数收敛:HSMO在30~35次迭代内可有效降低损失函数,可见下图。
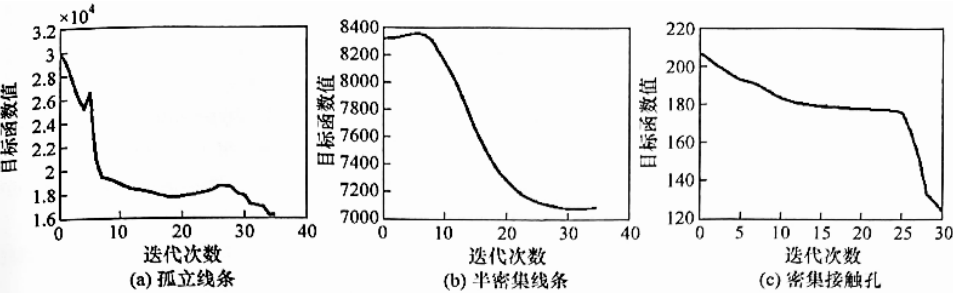
孤立线条、半密集线条和密集接触孔HSMO损失函数收敛曲线
PW对比:HSMO可显著扩展工艺窗口,如孤立线条在EL=3%时,DOF从146nm提升至257nm;OPC对PW扩展效果有限,可见下图和表格。
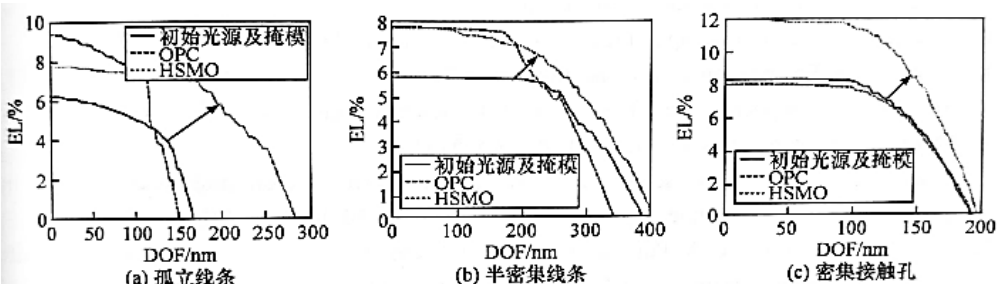
初始光源及掩模、OPC和HSMO对应的PW

对应FL=3%、5%和8%的DOF值,以及算法运行时间
06/结论
• 矢量HSMO技术通过联合优化光源与掩模,可在一维线条、二维接触孔等图形中有效扩展工艺窗口(PW),相比仅优化掩模的OPC技术具有更优的工艺变化稳定性。
• 仿真的运行时间与光源矩阵和掩模矩阵的尺寸有关。
07/先进技术与未来发展方向
当前,考虑工艺窗口(PW)的矢量SMO数值计算已实现关键突破:标准化仿真条件与精准测量点布设保障了数据可靠性,掩模延拓技术强化了边缘成像鲁棒性,规范化仿真参数与流程则提升了结果可复现性,显著扩展了先进制程的PW范围,支撑3nm节点量产良率提升。
未来,技术将向多维融合演进:AI赋能仿真模型实现PW与掩模延拓参数的自适应匹配;融入EUV多物理场耦合计算,提升复杂工艺下PW预测精度;构建跨流程协同框架,联动掩模制造与刻蚀工艺优化PW。极端制程下,量子化数值模型将成为核心,助力1nm及以下节点PW性能突破。
 网硕互联帮助中心
网硕互联帮助中心





评论前必须登录!
注册